微型化任務
現代電子產品的發展軌跡是無庸置疑的:裝置必須更小、更輕、更快、功能更豐富。這種對小型化和增強性能的不懈追求,為印刷電路板 (PCB) 的設計和製造帶來了巨大的壓力。儘管傳統的通孔 (TH) 和標準多層 PCB 仍能滿足許多應用,但複雜、高速和緊湊型裝置的崛起,必須將範式轉變為 高密度互連 技術.
對於設計工程師和專案經理而言,問題不在於 如果 HDI 較為優異,但 對於特定產品而言,HDI 的成本和複雜性何時才算合理? 採用 HDI 是一項關鍵的工程決策,會影響到從電路板尺寸、電氣效能到製造能力和整體系統成本等各方面。.
本指南提供以四個核心決策標準為基礎的全面架構,協助您評估下一個 PCBA 專案是否已跨入需要 HDI 技術的門檻。.

1.微型化因素:當空間成為主要限制因素時
採用 HDI 最直接、最明顯的驅動因素是 空間限制. .HDI 技術可大幅增加單位面積的佈線密度,通常可將電路板尺寸縮小以下 25% 至 50% 與傳統設計相比。.
微型化的關鍵指標:
A.高引腳數、細間距元件
HDI 最常見的觸發因素是採用先進元件,特別是 球閘陣列 (BGA) 和 晶片級封裝 (CSP) 具有極小間距的元件。.
- BGA 間距閾值: 如果您的設計採用具有 間距為 0.8 公釐或以下(例如 0.6 公釐、0.5 公釐或 0.4 公釐), 在這種情況下,使用標準的通孔(through-hole vias)從內部引腳排佈線就變得不可能或過於複雜。.
- HDI 解決方案:Via-in-Pad (VIP) 和 Microvias: HDI 利用 微型蟲 (直徑通常小於 0.15mm 的雷射鑽孔) 直接放置在元件的焊墊 (Via-in-Pad).這項技術騰出了 BGA 焊墊之間寶貴的表面區域來佈線,大幅提高了密度,並允許在更小的基底面上扇出高 I/O 數量的元件。.
B.元件密度與層數減少
在傳統 PCB 中,高密度設計通常會迫使增加總層數 (例如從 8 層增加到 12 層),以容納所有需要的跡線。HDI 通常可以用以下方法達到相同或更高的佈線複雜度 層數較少.
- 層數悖論: 8 層的標準 PCB 可能會被 4 層的 HDI 板取代,其中有兩層依序疊加 ($1+2+1$ 或類似結構)。儘管 HDI 的每層製造成本較高,但這可使最終的印刷電路板更薄、更輕,而且成本可能更低。.
- 應用: 對於 可穿戴裝置 (智慧型手錶、健身追蹤器)、, 智慧型手機、醫療植入物、, 以及高度受限的航太電子產品,在這些產品中,每一克、每一立方毫米都很重要。.
2.效能因素:當訊號完整性至關重要時
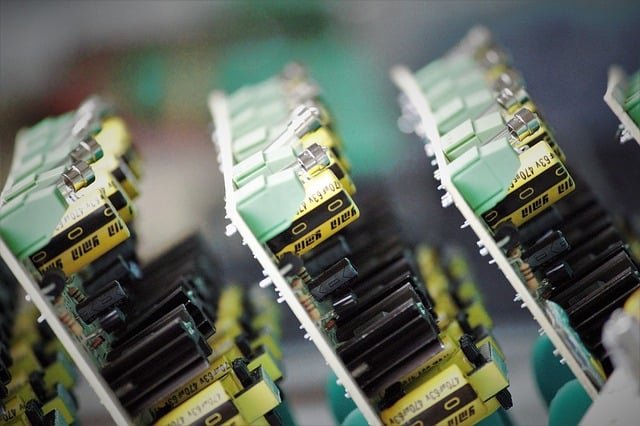
除了尺寸之外,HDI 的主要電氣優勢在於其管理能力。 高速和高頻 (RF) 訊號 具有卓越的誠信。.
訊號完整性需求的關鍵指標:
A.高速介面與資料速率
現代介面如 PCIe Gen 4/5、DDR4/5、USB 3.0/4.0 或 10G/40G 乙太網路 在長軌跡、反射和串音所造成的信號衰減是主要問題的頻率下運作。.
- 更短的訊號路徑: 微通孔只跨過一層或兩層(盲孔或埋孔),不像通孔會橫越所有層數,造成不需要的縫隙。 存根. .這種存根就像傳輸線的不連續,在高頻下會造成信號反射(雜訊)。HDI 的微通孔可有效 消除存根, 這可大幅改善訊號品質,並加快資料傳輸速度。.
- 更嚴格的阻抗控制: HDI 結構中使用的細線寬和受控介質厚度有助於更精確地控制特性阻抗(例如,用於 RF 的 $50\Omega$ 或用於資料的 $100\Omega$ 微分對),這對於最大限度地減少訊號損失和確保可靠性至關重要。.
B.供電網路 (PDN) 與 EMI 管理
高速處理器和 FPGA 需要乾淨、穩定的電源。HDI 結構本質上更適合電力傳輸網路 (PDN)。.
- 去耦電容放置: HDI 允許將微通孔直接放置在去耦電容的焊盤中(Via-in-Pad)。這可將電容與元件電源引腳之間的距離減至最小,從而降低寄生電感,並確保電源引腳與電容之間的距離。 更潔淨的動力傳輸 在大電流切換下,可全面降低電磁干擾 (EMI)。.
- 屏蔽: 使用堆疊和交錯微孔的能力可實現更堅固和連續的接地平面,這對於複雜的多功能裝置 (例如,具有 Wi-Fi、5G、GPS 和藍牙功能的智慧型手機) 進行有效的 EMI 屏蔽非常重要。.
3.可靠性因素:當耐用性和壽命是關鍵時

在嚴苛的環境中 (例如汽車、航太或工業控制),PCB 必須在使用壽命內承受巨大的熱力和機械壓力。.
增強可靠性的關鍵指標:
A.高熱循環應力
引擎控制單元 (ECU) 或戶外通訊系統所使用的元件會受到很大的溫度變化影響。.
- 較低的長寬比: HDI 板中的微孔與傳統通孔 (可達 8:1 或更高) 相比,具有明顯較低的高寬比(通孔深度與其直徑之比,通常為 1:1 或更低)。較低的長寬比意味著微通孔的圓筒在使用過程中不易發生破裂或疲勞失效。 熱循環 (板層的膨脹和收縮)。.
- 增加結構完整性: 透過以更小、更堅固的微孔取代大量的通孔,整個電路板的機械完整性得以提升,進而延長產品壽命,減少現場故障。.
B.法規和安全合規性
對於故障具有災難性的應用 (如醫療生命支持或航空飛行控制),HDI 的增強可靠性是符合要求的關鍵。在壓力下保證訊號完整性和結構耐用性的能力,使 HDI 成為這些領域的首選或強制技術。.
4.製造與成本因素:交叉點
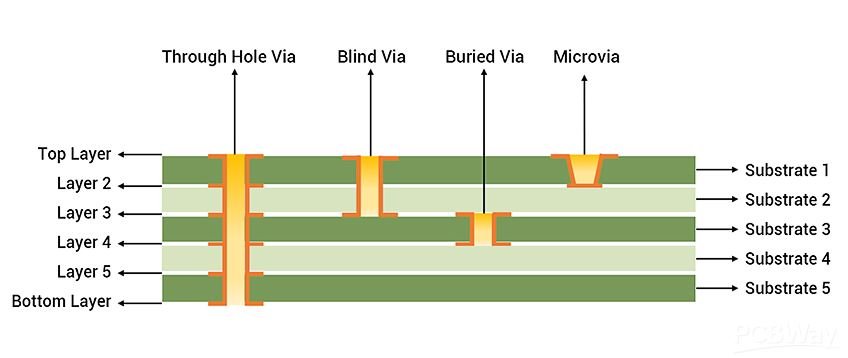
雖然 HDI 製造涉及較複雜的製程 (雷射鑽孔、順序貼合、銅填充),但整體系統成本在複雜度達到一定臨界值時,往往會偏向 HDI。.
主要製造考量:
A.交叉點:當複雜性簡化成本
最初的 HDI 製造 由於採用先進製程,成本較高。然而,傳統 PCB 若要達到相同的密度,可能需要不切實際的層數 (例如 14、16 或更多),或是過大的板面尺寸。.
- 成本效益: 一旦設計的複雜度將標準層數推到 8 或 10 層以上、, 減少電路板尺寸和總層數可節省成本 使用 $1+N+1$ 或 $2+N+2$ HDI 結構所增加的每層製造成本,往往比使用 $1+N+1$ 或 $2+N+2$ HDI 結構所增加的每層製造成本還要多。HDI 整合可節省材料、組裝時間和封裝成本。.
- 可製造性設計 (DFM): HDI 採用的 Via-in-Pad 技術實際上 簡化組裝 為 BGA 提供清晰、直接的連接,這對於高產量、自動化的 SMT 生產線非常重要。.
B.HDI 積層類型 (順序積層)
HDI 結構的類型是由所需的複雜性所定義的:
- I 型 ($1+N+1$): 每邊都有單層疊加。使用簡單的盲孔。(例如消費性筆記型電腦)
- Type II ($2+N+2$ Staggered): 每邊有兩層積層,其中 交錯微孔. .密度較高。(例如高階顯示卡)。
- 類型 III ($2+N+2$ 堆疊): 兩層或更多累積層,具有 堆疊和填充的微孔. .密度最高,是佈線超細間距 BGA 的必要條件。(例如智慧型手機、伺服器)。.
所需的 BGA 間距和 I/O 數量將決定所需的 HDI 類型,直接影響製程和價格。.
做出正確的 HDI 決定
過渡到 HDI 技術的決策,應該根據所討論的四個因素,對產品的需求進行嚴謹的分析: 空間、效能、可靠度與成本的交叉。.
| 決策標準 | 標準 PCB (建議) | HDI PCB (需求) |
| 微型化 | BGA 間距 $> 1.0 \text{mm}$;低元件密度;無嚴格尺寸限制。. | BGA 間距 $leq 0.8 \text{mm}$(特別是 $< 0.5 \text{mm}$);; 可穿戴設備、手持裝置、醫療植入物。. |
| 效能 | 資料速率 $< 1 \text{Gbps}$; 非關鍵阻抗; 低頻應用。. | 高速介面 (DDR4/5、PCIe Gen 4+);; RF 模組;需要嚴格的阻抗和 PDN 控制。. |
| 可靠性 | 受控環境;低熱循環。. | 汽車、航太、工業 系統;高溫或高機械應力環境。. |
| 成本交叉 | 層數可維持在 8 層以下;標準通孔足以進行佈線。. | 標準層數超過 10-12 層 以達成路由;系統尺寸的減少超過 NRE 成本。. |
身為 PCBA 快速生產服務供應商,我們的角色是與您合作,分析您的 Gerbers、BOM 和效能目標。透過識別 微孔、盲孔/埋孔和先進的順序貼合-我們確保以最具成本效益且最可靠的製造解決方案,滿足您產品的效能與尺寸目標。.
您是否有特定的 BGA 元件或資料傳輸率需求,希望我們進行初步 HDI 可行性評估分析?




