Der Auftrag zur Miniaturisierung
Die Entwicklung der modernen Elektronik ist unbestreitbar: Die Geräte müssen kleiner, leichter, schneller und mit mehr Funktionen ausgestattet sein. Dieser unerbittliche Drang nach Miniaturisierung und verbesserter Leistung hat einen immensen Druck auf das Design und die Herstellung von Leiterplatten (PCB) ausgeübt. Während herkömmliche Through-Hole- (TH) und Standard-Multilayer-Leiterplatten nach wie vor viele Anwendungen bedienen, erfordert die Zunahme komplexer, schneller und kompakter Geräte einen Paradigmenwechsel hin zu High-Density-Verbindung Technologie.
Für Konstrukteure und Projektleiter stellt sich nicht die Frage wenn HDI ist überlegen, aber wann sind die Kosten und die Komplexität von HDI für ihr spezifisches Produkt gerechtfertigt? Die Einführung von HDI ist eine wichtige technische Entscheidung, die sich auf alles auswirkt, von der Größe der Leiterplatte und der elektrischen Leistung bis hin zur Herstellbarkeit und den Gesamtsystemkosten.
Dieser Leitfaden bietet ein umfassendes Rahmenwerk, das auf vier zentralen Entscheidungskriterien basiert, um Ihnen bei der Beurteilung zu helfen, ob Ihr nächstes PCBA-Projekt die Schwelle zur HDI-Technologie überschritten hat.

1. Der Faktor der Miniaturisierung: Wenn der Platz die wichtigste Einschränkung ist
Der unmittelbarste und offensichtlichste Grund für die Einführung von HDI ist Platzbeschränkung. Die HDI-Technologie ermöglicht eine drastische Erhöhung der Verdrahtungsdichte pro Flächeneinheit, was häufig eine Reduzierung der Leiterplattengröße um 25% bis 50% im Vergleich zu einer herkömmlichen Konstruktion.
Schlüsselindikatoren für die Miniaturisierung:
A. High-Pin-Count, Fine-Pitch Komponenten
Der häufigste Auslöser für HDI ist die Einführung fortschrittlicher Komponenten, insbesondere Ball Grid Array (BGA) und Chip Scale Package (CSP) Komponenten mit extrem kleinen Spielfeldern.
- BGA-Teilungsschwellenwert: Wenn Ihr Entwurf BGA-Gehäuse mit einem Abstand von 0,8 mm oder weniger (z. B. 0,6 mm, 0,5 mm oder 0,4 mm), Bei der Verwendung von Standard-Durchgangslöchern wird das Entflechten der Leiterbahnen aus den inneren Stiftreihen unmöglich oder übermäßig komplex.
- HDI-Lösung: Via-in-Pad (VIP) und Microvias: HDI nutzt Microvias (lasergebohrte Löcher mit einem Durchmesser von in der Regel weniger als 0,15 mm), die direkt im Lötauge des Bauteils (Via-in-Pad). Durch diese Technik wird wertvolle Fläche zwischen den BGA-Pads für das Verlegen von Leiterbahnen frei, was die Dichte drastisch erhöht und das Auffächern von Komponenten mit hoher E/A-Anzahl auf kleinerer Grundfläche ermöglicht.
B. Reduzierung der Komponentendichte und Lagenzahl
Bei herkömmlichen Leiterplatten erzwingen Designs mit hoher Packungsdichte oft eine Erhöhung der Gesamtzahl der Lagen (z. B. von 8 auf 12 Lagen), um alle erforderlichen Leiterbahnen unterzubringen. HDI kann oft die gleiche oder eine höhere Routing-Komplexität erreichen mit weniger Schichten.
- Das Layer-Count-Paradoxon: Eine 8-Lagen-Standardleiterplatte könnte durch eine 4-Lagen-HDI-Leiterplatte mit zwei aufeinanderfolgenden Aufbaulagen ($1+2+1$ oder eine ähnliche Struktur) ersetzt werden. Dies führt zu einer dünneren, leichteren und potenziell kostengünstigeren endgültigen Leiterplatte, trotz der höheren Herstellungskosten pro Schicht bei HDI.
- Anwendungen: Dies ist nicht verhandelbar für tragbare Geräte (Smartwatches, Fitness-Tracker), Smartphones, medizinische Implantate, und hochbeanspruchte Luft- und Raumfahrtelektronik, bei der jedes Gramm und jeder Kubikmillimeter zählt.
2. Der Leistungsfaktor: Wenn Signalintegrität an erster Stelle steht
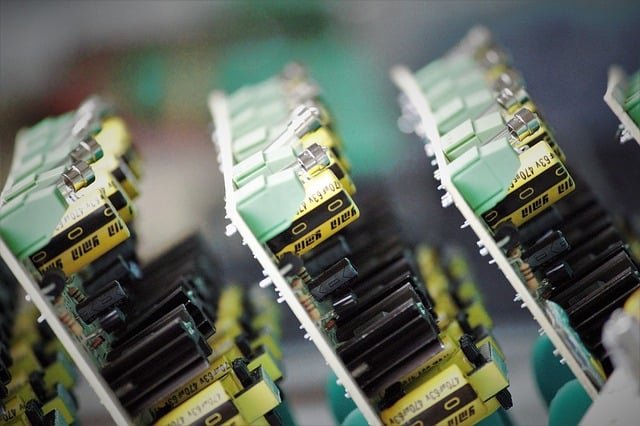
Abgesehen von der Größe liegt der primäre elektrische Vorteil von HDI in seiner Fähigkeit zur Verwaltung Hochgeschwindigkeits- und Hochfrequenzsignale (RF) mit höchster Integrität.
Schlüsselindikatoren für die Anforderungen an die Signalintegrität:
A. Hochgeschwindigkeitsschnittstellen und Datenraten
Moderne Schnittstellen wie PCIe Gen 4/5, DDR4/5, USB 3.0/4.0, oder 10G/40G Ethernet arbeiten bei Frequenzen, bei denen eine Signalverschlechterung aufgrund von langen Leitungen, Reflexionen und Übersprechen ein großes Problem darstellt.
- Kürzere Signalwege: Microvias überspannen nur eine oder zwei Schichten (Blind oder Buried Vias), im Gegensatz zu Durchgangsbohrungen, die alle Schichten durchqueren und eine unerwünschte Stummel. Diese Stichleitung wirkt wie eine Diskontinuität in der Übertragungsleitung und verursacht Signalreflexionen (Rauschen) bei hohen Frequenzen. HDI's Mikrovias effektiv den Stumpf zu beseitigen, Dadurch wird die Signalqualität drastisch verbessert und eine höhere Datenübertragungsgeschwindigkeit ermöglicht.
- Straffere Impedanzkontrolle: Die feinen Leitungsbreiten und kontrollierten dielektrischen Dicken, die bei der HDI-Konstruktion verwendet werden, ermöglichen eine präzisere Kontrolle der charakteristischen Impedanz (z. B. $50\Omega$ für RF oder $100\Omega$-Differenzpaare für Daten), was für die Minimierung von Signalverlusten und die Gewährleistung der Zuverlässigkeit entscheidend ist.
B. Stromversorgungsnetz (PDN) und EMI-Management
Hochgeschwindigkeitsprozessoren und FPGAs benötigen eine saubere, stabile Stromversorgung. HDI-Strukturen sind von Natur aus besser für Power Delivery Networks (PDN) geeignet.
- Platzierung des Entkopplungskondensators: HDI ermöglicht die Platzierung von Mikrovias direkt im Pad von Entkopplungskondensatoren (Via-in-Pad). Dies minimiert den Abstand zwischen dem Kondensator und dem Power-Pin des Bauteils, reduziert die parasitäre Induktivität und gewährleistet sauberere Leistungsabgabe bei hohen Schaltströmen, wodurch die elektromagnetische Interferenz (EMI) auf breiter Front verringert wird.
- Abschirmung: Die Möglichkeit, gestapelte und versetzte Microvias zu verwenden, ermöglicht robustere und durchgängige Masseflächen, die für eine wirksame EMI-Abschirmung in komplexen, multifunktionalen Geräten (z. B. ein Smartphone mit Wi-Fi, 5G, GPS und Bluetooth) unerlässlich sind.
3. Der Faktor Verlässlichkeit: Wenn Haltbarkeit und Langlebigkeit entscheidend sind

In anspruchsvollen Umgebungen - wie z. B. in der Automobil-, Luft- und Raumfahrtindustrie oder bei industriellen Steuerungen - müssen Leiterplatten während ihrer gesamten Lebensdauer erheblichen thermischen und mechanischen Belastungen standhalten.
Schlüsselindikatoren für mehr Zuverlässigkeit:
A. Hohe thermische Wechselbelastung
Komponenten, wie sie in Motorsteuergeräten (ECU) oder Außenkommunikationssystemen verwendet werden, sind großen Temperaturschwankungen ausgesetzt.
- Niedrigeres Seitenverhältnis: Microvias in HDI-Platinen haben ein deutlich geringeres Aspektverhältnis (das Verhältnis von Via-Tiefe zu Via-Durchmesser, oft 1:1 oder weniger) im Vergleich zu herkömmlichen Durchkontaktierungen (die 8:1 oder mehr betragen können). Ein geringeres Seitenverhältnis bedeutet, dass die Microvia-Hülsen weit weniger anfällig für Risse oder Ermüdungsbrüche während der Temperaturwechselbeanspruchung (Ausdehnung und Zusammenziehen der Plattenschichten).
- Erhöhte strukturelle Integrität: Durch den Ersatz einer großen Anzahl von Durchgangslöchern durch kleinere, robustere Microvias wird die mechanische Integrität der gesamten Leiterplatte verbessert, was zu einer längeren Produktlebensdauer und weniger Feldausfällen führt.
B. Einhaltung von Vorschriften und Sicherheit
Für Anwendungen, bei denen ein Ausfall katastrophale Folgen haben kann (z. B. medizinische Lebenserhaltung oder Flugsteuerungen in der Luft- und Raumfahrt), ist die erhöhte Zuverlässigkeit von HDI eine wichtige Voraussetzung für die Einhaltung der Vorschriften. Die Fähigkeit, Signalintegrität und strukturelle Beständigkeit unter Belastung zu garantieren, macht HDI zu einer bevorzugten oder vorgeschriebenen Technologie in diesen Bereichen.
4. Der Produktions- und Kostenfaktor: Der Kreuzungspunkt
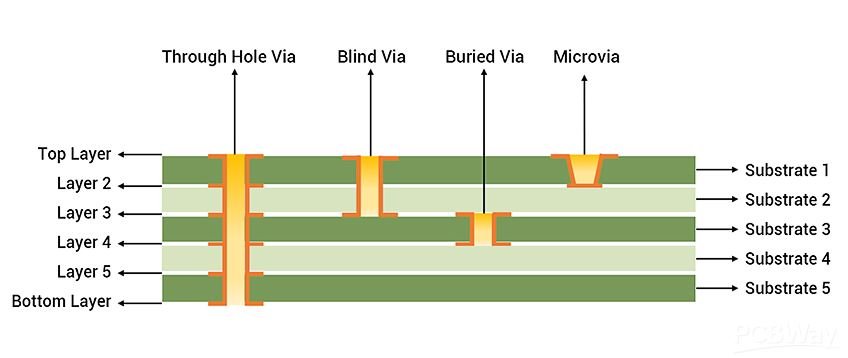
Die Herstellung von HDI ist zwar mit komplexeren Prozessen verbunden (Laserbohren, sequentielles Laminieren, Kupferfüllung), aber ab einer bestimmten Komplexitätsschwelle können die Gesamtsystemkosten oft zugunsten von HDI ausfallen.
Wichtige Überlegungen zur Herstellung:
A. Der Kreuzungspunkt: Wenn Komplexität die Kosten vereinfacht
Die ursprüngliche HDI-Herstellung Die Kosten sind aufgrund der fortschrittlichen Verfahren höher. Eine herkömmliche Leiterplatte, mit der dieselbe Dichte erreicht werden soll, könnte jedoch eine unpraktische Anzahl von Lagen (z. B. 14, 16 oder mehr) oder eine übermäßige Größe der Platte erfordern.
- Kosteneffizienz: Sobald die Komplexität des Entwurfs die Anzahl der Standardschichten auf über 8 oder 10 Schichten ansteigen lässt, die Kosteneinsparungen durch die Verringerung der Leiterplattengröße und der Gesamtzahl der Lagen bei Verwendung einer $1+N+1$ oder $2+N+2$ HDI-Struktur überwiegen oft die höheren Herstellungskosten pro Schicht. Die HDI-Konsolidierung kann zu Einsparungen bei den Materialien, der Montagezeit und den Gehäusekosten führen.
- Design für Herstellbarkeit (DFM): Die Verwendung der Via-in-Pad-Technologie durch HDI vereinfacht die Montage durch die Bereitstellung klarer, direkter Verbindungen für BGAs, was für hochvolumige, automatisierte SMT-Linien entscheidend sein kann.
B. HDI-Aufbauarten (Sequentielle Laminierung)
Die Art der HDI-Struktur wird durch die erforderliche Komplexität bestimmt:
- Typ I ($1+N+1$): Einzelne Aufbauschicht auf jeder Seite. Verwendet einfache Blind Vias. (z. B. Laptops für Verbraucher)
- Typ II ($2+N+2$ gestaffelt): Zwei Aufbauschichten auf jeder Seite mit Gestaffelte Mikrovias. Höhere Dichte. (z. B. High-End-Grafikkarten)
- Typ III ($2+N+2$ gestapelt): Zwei oder mehr Aufbauschichten mit Gestapelte und gefüllte Microvias. Höchste Dichte, unerlässlich für das Routing von BGAs mit ultrafeinem Pitch. (z. B. Smartphones, Server).
Der erforderliche BGA-Abstand und die Anzahl der E/As bestimmen, welcher HDI-Typ erforderlich ist, was sich direkt auf den Herstellungsprozess und den Preis auswirkt.
Die richtige HDI-Entscheidung treffen
Die Entscheidung für den Übergang zur HDI-Technologie sollte auf einer kalten, harten Analyse der Produktanforderungen unter Berücksichtigung der vier genannten Faktoren beruhen: Platz, Leistung, Zuverlässigkeit und Kosten Crossover.
| Kriterien für die Entscheidung | Standard PCB (Empfehlung) | HDI PCB (Anforderung) |
| Miniaturisierung | BGA-Abstand $> 1,0 \text{mm}$; geringe Bauteildichte; keine strengen Größenbeschränkungen. | BGA-Abstand $\leq 0,8 \text{mm}$ (insbesondere $< 0,5 \text{mm}$); Wearables, Handheld-Geräte, medizinische Implantate. |
| Leistung | Datenraten $< 1 \text{Gbps}$; Unkritische Impedanz; Niederfrequenzanwendungen. | Hochgeschwindigkeitsschnittstellen (DDR4/5, PCIe Gen 4+); RF-Module; strenge Impedanz- und PDN-Kontrolle ist erforderlich. |
| Verlässlichkeit | Kontrollierte Umgebung; geringe Temperaturschwankungen. | Automobilindustrie, Luft- und Raumfahrt, Industrie Systeme; Umgebung mit hoher thermischer oder mechanischer Belastung. |
| Kosten Crossover | Die Anzahl der Lagen kann unter 8 gehalten werden; Standard-Durchgangslöcher reichen für die Verlegung aus. | Die Standardschichtenzahl übersteigt 10-12 Schichten um Routing zu erreichen; die Reduzierung der Systemgröße überwiegt die NRE-Kosten. |
Als PCBA-Schnellfertigungsdienstleister ist es unsere Aufgabe, gemeinsam mit Ihnen Ihre Gerber, Stücklisten und Leistungsziele zu analysieren. Durch die Identifizierung des Bedarfs an Microvias, Blind/Buried Vias und fortschrittliche sequentielle Laminierung-die entscheidenden Merkmale von HDI- stellen wir sicher, dass die Leistungs- und Größenvorgaben Ihres Produkts mit der kostengünstigsten und zuverlässigsten Fertigungslösung erfüllt werden.
Haben Sie eine bestimmte BGA-Komponente oder Datenratenanforderung, die wir für eine erste HDI-Machbarkeitsbewertung analysieren sollen?




